
老伙计网消息,相对于其他环节,封测行业技术壁垒和国际限制较少,同时得益于终端电子产品的旺盛需求以及国际先进封装测试企业的引进,为我国集成电路封装测试业行业水平提高与发展带来了巨大的机遇。封测环节相对于其他环节而言对资金和技术的要求相对较低,有望率先实现国产替代,也就是说不太容易被国外“卡脖子”,而大陆的封测厂商们因近年来通过内生发展与外延并购实现营业收入快速增长,已经成为全球封测产业重要力量。
随着全球半导体行业市场规模的增长,大陆封测行业迎来了良好的发展机遇。中国大陆封测市场份额逐步扩大,已经从2016年的14%提升至2019年的28%,影响力日益凸显。

根据中国半导体协会统计,2019年,大陆封测企业数量已经超过了120家,自2012年至2018年,封装测试业的市场规模从2012年的1034亿元,增长至2018年的2196亿元,复合增速为13.38%。2020年上半年我国集成电路产业销售额为3539亿元,同比增长16.1%。其中封装测试业销售额1082.4亿元,同比增长5.9%。
市场增长迅猛,下半年露出明显回暖迹象
全球半导体市场在2019年经历了近十年最大幅度的下滑,业内原本预期2020年将会开始复苏,但是先后席卷中国和全球的新冠肺炎疫情,以及中美科技冷战的影响,使得这种复苏态势在今年上半年发生了逆转。不过从多家大陆代表厂商上半年或前三个季度的业绩来看,封测市场的回暖已经到来。
受益于我国疫情防控成效和快速复工复产,我国经济发展先降后升,经济运行总体向好,并且随着我国加快推进以5G、工业互联网、大数据、人工智能等为代表的“新基建”基础设施的建设,加速了集成电路国产替代进程。2020年上半年我国集成电路设计业成为三业中增速最大的子行业,为芯片制造和封装测试企业带来大量订单。
根据TrendForce旗下拓墣产业研究院公布的2020年第二季度全球十大封测企业应收排名,江苏长电、天水华天和通富微电二季度分别名列四、六、七名。
江苏长电发布的2020年上半年的业绩报告显示,上半年实现营业收入为119.76亿元,同比增长30.91%;归属于上市公司股东的净利润为3.66亿元,净利实现扭亏为盈;
华天科技上半年实现营收37.15亿元,同比下跌3.25%;归属于上市公司股东的净利润为2.67亿元,同比大增211.85%。
通富微电上半年整体营业收入46.70亿元,较去年同期增长30.17%,2020年上半年较去年同期实现扭亏为盈,净利润达1.11亿元,同比增长243.54%。
除此之外,几家典型的中小型封测企业也都表示出了对下半年业绩的极大信心。
四川明泰电子总经理郑渠江对老伙计网记者表示,今年上半年公司业绩相比去年同期增长了30%,下半年预计将会增长更高。1~8月已经超越了去年全年的利润,预计今年全年利润率将会达到50%左右。“为了尽快解决产能紧张的遗憾,最近投资了近一亿元人民币来扩充产能。”
另一家小型先进封装厂商表示,由于疫情影响的滞后性,对二季度的业绩造成了一定程度的影响,导致今年上半年业绩一般。但是现在已经可以看到,三季度将会开始暖。
而晶圆测试厂商表示,“今年业绩很好,有望实现翻倍。”
新封测项目花落多地,先进封装稍显不足
据SEMI数据统计,2020年全球将有18个半导体项目投入建设,其中有11个集中在国内,总投资规模将达到240亿美元。半导体项目不断涌现,产能陆续释放,反过来为封测行业带来更大的需求。
随着封测行业景气上行以及政策大力推动下,今年以来全国多个城市宣布新的封测项目落地。
例如最近由智路资本全资收购全球第七大集成电路封测企业、第三大汽车电子封装测试企业新加坡联合科技公司(UTAC),将全球领先的车规级、晶圆级封装技术引入烟台,在烟台开发区建设全球一流的封测基地及研发中心;
总投资25亿元的方芯电子集成电路先进封测项目落户嘉兴;
年产光芯片测试产品1亿只的徐州芯思杰5G光芯片封测项目投产……
遍地开花的封测项目不由得让人担心重复建设和建成后订单问题。从技术角度看,在深度摩尔、超越摩尔、应用多元化的驱动下,先进封装技术将发挥越来越重要的作用,在这方面,台积电和三星都已早早布局,这两家全球最顶尖技术的晶圆代工厂商,当前除了在先进制程上的竞赛之外,还将战场扩展到先进封装的范围中,藉此以掌握未来的商机。
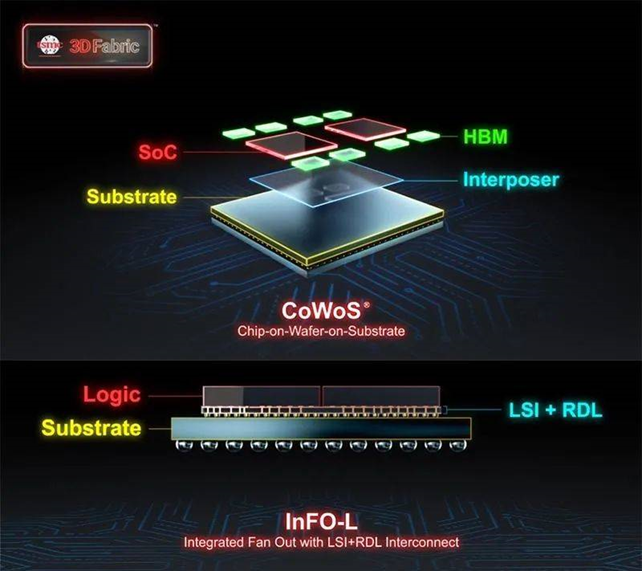
今年8月底,台积电推出3DFabric整合技术平台,将CoWoS、InFO-R、Chip on Wafer、Wafer on Wafer等先进3D封装技术平台汇整,未来将统一命名为“TSMC 3DFabric”,未来此平台将持续提供介面连结解决方案,以达成客户整合逻辑芯片、高频宽存储器及特殊制程芯片的需求。
和台积电相似,英特尔也早已在封装领域布局了多种维度的先进封装技术。在8月13日的2020年英特尔架构日上,英特尔发布一个全新的混合结合(Integrated Fan-out)技术,使用这一技术的测试芯片已在2020年第二季度流片。
而三星的3D芯片先进封装技术订名为“eXtended-Cube”,简称“X-Cube”,在8月中旬已经进行展示,在当中将采用7纳米制程技术,来为客户提供相关的产品。
可以看到,在2020年,围绕3D封装技术的战火继续升级,在先进封装领域,大陆封测与国际龙头仍存在较大差距,且在台积电、三星等晶圆和IDM厂商持续加码先进封装的情况下,围绕先进封装技术的争夺会更加激烈。
2020年,围绕3D封装技术的战火继续升级,藉由先进封装的发展则会是下一代半导体决胜的关键。因此,谁能够掌握其中的关键,谁就能在竞争中取得致胜的先机。在这方面,大陆封测厂商的整体布局还是稍显落后一些。
(校对/零叁)



